提高性能
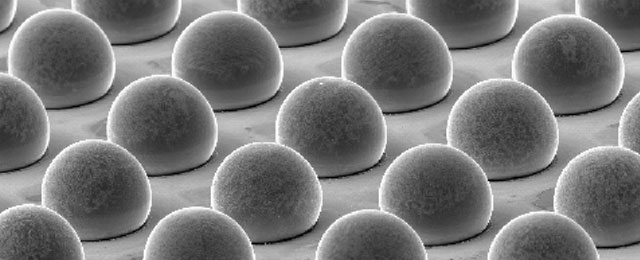
我司晶圆凸块工艺专为新兴技术而设计,例如 3-D 封装。 我们的工艺包括铜凸块/铜柱/杆、铜重布线层(RDL)、镍、锡凸块、金凸块和硅通孔(TSV)。 所有工艺都提供了改善的性能和更高的成本效益,同时还满足了环境,健康和公共安全。
铜柱/杆
MICROFAB CU 1000 工艺专为高速铜柱、铜重布线层(RDL)和铜凸块/ UBM 应用而设计。 它根据严格的半导体行业要求进行配制、包装和质量控制。 MICROFAB CU 1000 工艺具有 10 至 35 ASD的宽电流密度范围(约 2 至 7μm/min)。 最大可实现的电流密度取决于设备工具流动力学设计,光阻高度和晶圆图案密度和复杂性。
阅读更多铜重布线层(RDL)
MICROFAB SC-40 和 MICROFAB SC-50 高速铜工艺应用于各种半导体制造工艺。 这些工艺可为最复杂的晶圆布局提供精确的凸块高度均匀性和凸块形状控制,同时保持低沉积内应力,一致的沉积速率和广泛的添加剂工艺操作窗口。
阅读更多金凸块
MICROFAB AU 系列是非氰化物,弱碱性电镀工艺,可沉积细致、高纯度、优秀厚度分布的金镀层。MICROFAB AU 系列工艺专门用于半导体晶圆上的凸块和电路图案电镀。
阅读更多镍UBM
MICROFAB NI 系列是氨基磺酸镍电镀工艺,可生产高纯度、具延展性、细致、低应力镍沉积物。高性能工艺可轻松满足半导体行业对晶圆电镀化学工艺的严格对质量与性能要求。 MICROFAB NI 系列工艺含有可控量的阳极活化剂,以增强阳极腐蚀并防止阳极钝化。镀层易于控制和维护。
阅读更多硅通孔(TSV)
MICROFAB DVF 200 酸性镀铜工艺填充硅通孔(TSV),在高电镀速度下无空隙和其他缺陷。该工艺专门针对孔直径范围为 5 至 20μm ,深宽比小于 10 的孔而设计。MICROFAB DVF 200技终端应用在一些关键电子产品如 CMOS 图像传感器(例如数码相机),中介板, DRAM 和闪存记忆体。
阅读更多锡凸块
MICROFAB 凸块电镀化学品是经过量产验证的强大电镀工艺,可根据客户的要求量身定制,适用于高速制造工艺,生产出无铅,高度可焊接的材料。
阅读更多